2021-06-03 10:42
可靠性(Reliability)是对产品耐久力的测量,我们主要典型的IC产品的生命周期可以用一条浴缸曲线(Bathtub Curve)来表示。
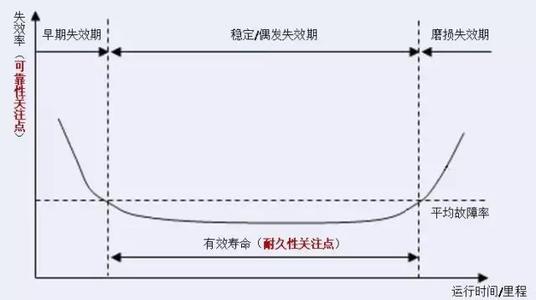
如上图示意,集成电路的失效原因大致分为三个阶段:
Region (I) 被称为早夭期(Infancy period), 这个阶段产品的失效率快速下降,造成失效的原因在于IC设计和生产过程中的缺陷;
Region (II) 被称为使用期(Useful life period), 这个阶段产品的失效率保持稳定,失效的原因往往是随机的,比如温度变化等等;
Region (III) 被称为磨耗期(Wear-Out period) 这个阶段产品的失效率会快速升高,失效的原因就是产品的长期使用所造成的老化等。
军工级器件老化筛选
元器件寿命试验
ESD等级、Latch_up测试评价
高低温性能分析试验
集成电路微缺陷分析
封装缺陷无损检测及分析
电迁移、热载流子评价分析
目的:评估工艺的稳定性,加速缺陷失效率,去除由于天生原因失效的产品
测试条件:在特定时间内动态提升温度和电压对产品进行测试
失效机制:材料或工艺的缺陷,包括诸如氧化层缺陷,金属刻镀,离子玷污等由于生产造成的失效
参考标准:
JESD22-A108-A
EIAJED- 4701-D101
目的:评估器件在超热和超电压情况下一段时间的耐久力
测试条件: 125℃,1.1VCC, 动态测试
失效机制:电子迁移,氧化层破裂,相互扩散,不稳定性,离子玷污等
参考数据:
125℃条件下1000小时测试通过IC可以保证持续使用4年,2000小时测试持续使用8年;150℃ 1000小时测试通过保证使用8年,2000小时保证使用28年
参考标准:
MIT-STD-883E Method 1005.8
JESD22-A108-A
EIAJED- 4701-D101
目的:模拟IC在使用之前在一定湿度,温度条件下存储的耐久力,也就是IC从生产到使用之间存储的可靠性
目的:评估IC产品在高温,高湿,偏压条件下对湿气的抵抗能力,加速其失效进程
测试条件:85℃,85%RH, 1.1 VCC, Static bias
失效机制:电解腐蚀
参考标准:
JESD22-A101-D
EIAJED- 4701-D122
目的:评估IC产品在偏压下高温,高湿,高气压条件下对湿度的抵抗能力,加速其失效过程
测试条件:130℃, 85%RH, 1.1 VCC, Static bias,2.3 atm
失效机制:电离腐蚀,封装密封性
参考标准:
JESD22-A110
目的:评估IC产品在高温,高湿,高气压条件下对湿度的抵抗能力,加速其失效过程
测试条件:130℃, 85%RH, Static bias,15PSIG(2 atm)
失效机制:化学金属腐蚀,封装密封性
参考标准:
JESD22-A102
EIAJED- 4701-B123
*HAST与THB的区别在于温度更高,并且考虑到压力因素,实验时间可以缩短,而PCT则不加偏压,但湿度增大。
目的:评估IC产品中具有不同热膨胀系数的金属之间的界面的接触良率。方法是通过循环流动的空气从高温到低温重复变化
测试条件:
Condition B:-55℃ to 125℃
Condition C: -65℃ to 150℃
失效机制:电介质的断裂,导体和绝缘体的断裂,不同界面的分层
参考标准:
MIT-STD-883E Method 1010.7
JESD22-A104-A
EIAJED- 4701-B-131
目的:评估IC产品中具有不同热膨胀系数的金属之间的界面的接触良率。方法是通过循环流动的液体从高温到低温重复变化
测试条件:
Condition B: - 55℃ to 125℃
Condition C: - 65℃ to 150℃
失效机制:电介质的断裂,材料的老化(如bond wires), 导体机械变形
参考标准:
MIT-STD-883E Method 1011.9
JESD22-B106
EIAJED- 4701-B-141
* TCT与TST的区别在于TCT偏重于package 的测试,而TST偏重于晶园的测试
目的:评估IC产品在实际使用之前在高温条件下保持几年不工作条件下的生命时间
测试条件:150℃
失效机制:化学和扩散效应,Au-Al 共金效应
参考标准:
MIT-STD-883E Method 1008.2
JESD22-A103-A
EIAJED- 4701-B111
目的:评估IC leads在粘锡过程中的可靠度
测试方法:
Step1:蒸汽老化8 小时
Step2:浸入245℃锡盆中 5秒
失效标准(Failure Criterion):至少95%良率
具体的测试条件和估算结果可参考以下标准
MIT-STD-883E Method 2003.7
JESD22-B102
目的:评估IC 对瞬间高温的敏感度
测试方法:侵入260℃ 锡盆中10秒
失效标准(Failure Criterion):根据电测试结果
具体的测试条件和估算结果可参考以下标准
MIT-STD-883E Method 2003.7
EIAJED- 4701-B106
目的:评估非挥发性memory器件在多次读写算后的持久性能
Test Method:将数据写入memory的存储单元,在擦除数据,重复这个过程多次
测试条件:室温,或者更高,每个数据的读写次数达到100k~1000k
参考标准:
MIT-STD-883E Method 1033
目的:在重复读写之后加速非挥发性memory器件存储节点的电荷损失
测试条件:在高温条件下将数据写入memory存储单元后,多次读取验证单元中的数据
失效机制:150℃





